图 13 电子制造产业链整合趋势2
如此,封装厂需要提供:从芯片封装到系统集成的整体解决方案;具备系统设计和测试能力;除了传统芯片封装之外,EMI防护,3D/嵌入式封装结构,嵌入式天线等高集成度方案的know how,都将由封装厂来掌握。进一步而言,封装厂将从单纯地为某一家IC设计企业提供芯片封装方案,转变成为下游的整机商提供完整的系统解决方案。
PLP(Panel Level Package)将会对原有电子制造产业链做最深刻的整合
随着SiP封装技术的不断发展,越来越多的元器件被埋入IC载板,原来的埋入被动元件已经司空见惯,埋入主动元件如IC等正方兴未艾,以进一步提升集成度,见图14。
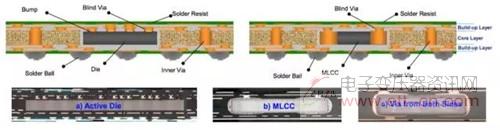
图 14 PLP
同时,随着IC制造领域的光刻对位技术的逐步提升,晶圆尺寸逐渐由200mm、300mm向450mm、500mm的大拼板方向提升,所以越来越多的科技工作者认为,如果直接将IC等主动元件和其他被动元件在PCB 大拼板加工过程中直接埋入,那将大大缩短整个电子制造产业链,见图15。

图 15 电子制造产业链整合趋势3
目前已有多个电子行业从业单位开发出相应的PLP产品,有PCB厂家AT&S的ECP(Embedded Components Packaging),有IC封装厂家ASE的a-EASI(advanced-Embedded Assembly Solution Integration),也有IC载板厂家Kinsus的EAS(Embedded Actives Substrate)。
综上所述,在后摩尔定律时代,加速电子产业链上下游的整合势在必行,苹果公司的iPhone A11 InFo WLP和Apple Watch S1 SiP正是这种趋势的最佳见证。这也是PCB从业者在后摩尔时代所应该看到和追随的。无论是Fan-Out WLP的类载板还是SiP的载板均需要使用到MSAP和SAP等类似精细线路加工技术,所以当前PCB行业的发展方向应该相对明确,就是开发MSAP和SAP精细线路加工技术。同时,鉴于目前电子制造行业整合趋势明显,融合了SMT贴装技术(Picking and Placing Machine)和PCB制造技术的埋入元器件技术将会同步得到发展,也是我们PCB行业远期重点关注对象。

(敬请关注微信号:dzbyqzx)