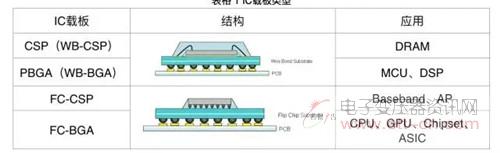
IC载板精细线路加工技术
随着IC设计节点的不断缩小,IC尺寸也不断缩小,从而导致了IC封装时的Bump pitch也逐渐缩小,从下图可以看出,当IC Bump Pitch在150um以下时,常规的tenting酸蚀流程加工已经无法满足IC载板的精细线路加工要求,必须采用MSAP、SAP或是类似流程。这是IC载板区别于PCB的第二大特点。
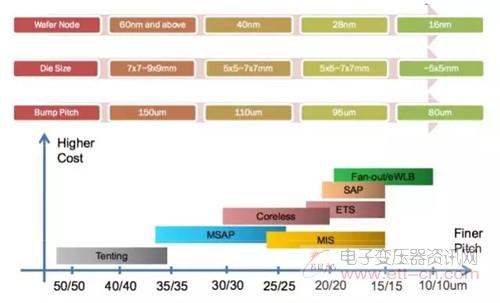
图 8 IC载板精细线路加工技术
WLP及SLP
晶圆级封装(WLP,Wafer Level Package) 的一般定义为直接在晶圆上进行大多数或是全部的封装测试程序,之后再进行切割(singulation)制成单颗组件。而重新分配(redistribution layer, RDL)与凸块(bump)技术为其I/O布线的一般选择,从而摆脱了对IC载板的依赖,封装成本大大降低。WLP封装具有较小封装尺寸(CSP),但同时,由于凸块全部位于芯片下方,I/O数受到大大限制,所以,WLP封装一般又称为WLCSP或是Fan-In WLP,目前多用于低脚数消费性IC的封装应用。
伴随IC芯片I/O数目增加,对锡球间距(Ball Pitch)的要求更加严格, 目前Ball Pitch已经发展至0.35mm,如果持续降低,将会造成下游PCB制造成本大大增加,于是Fan-Out WLP应运而生,见图9:所谓Fan-Out,即I/O bump可以通过RDL层扩展至IC芯片周边,在满足I/O数增大的前提下又不至于使Ball Pitch过于缩小从而影响PCB加工,见图10。
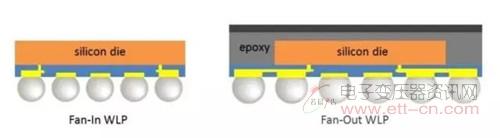
图 9 Fan-In and Fan-Out
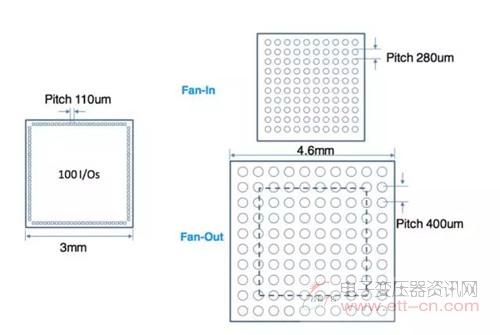
图 10 Fan-Out WLP
当然,Fan-Out WLP除了满足不断增加的I/O数的需求外,最大的特点就是其采用RDL层布线代替了传统IC封装所需的IC载板,从而大大降低了整体封装厚度,这一点极大地适应了消费类电子尤其是智能手机对厚度的极端苛求。基于此点,传统的FC-CSP和FC-BGA封装也逐渐向Fan-Out WLP过渡,当然也可理解为Fan-Out WLP是Fan-In WLP和FC载板封装的技术融合,见图11。可见Fan-Out WLP发展前景非同一般。
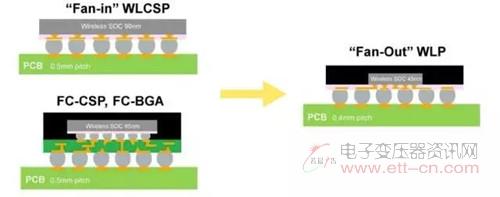
图 11 Fan-Out WLP发展趋势
伴随Fan-Out WLP技术兴起,相配套的PCB由于使用了IC载板的精细线路加工技术MSAP,其加工难度却又远高于常规HDI。另外,由于IC芯片采用Fan-Out WLP后,已经不再是裸芯片(IC载板是裸芯片封装,这也是IC载板区别于PCB的第三大特点),所以与之配套的PCB并不能称为载板,根据目前苹果电子产业链的业内人士所述,把采用Fan-Out WLP封装和采用MSAP工艺加工的PCB称为类载板PCB(SLP,Substrate-like PCB)。Apple 2016年发布的iPhone7的A10 Fusion已经采用TSMC InFoWLP工艺,但PCB仍然采用酸蚀流程,据了解,2017的A11芯片也将延续TSMC InFoWLP工艺,并且已经确定PCB采用MSAP流程,所以,类载板PCB的定义和技术指标也变得更加具体,见表格2: