
图 4 Apple Watch S1
从以上苹果公司最新的技术应用分析,我们可以看出,苹果、台积电、日月光和富士康四亲兄弟分别代表着IC设计、IC制造、IC封装和SMT四个领域正忠实地沿着深度摩尔和超越摩尔的路线前行,引领者整个电子制造行业的发展与变革,同时也潜移默化地影响着PCB制造者和IC载板制造者。作为PCB制造的从业者,更需要擦亮眼睛,做到envision it,enable it,只有这样才能永葆。下面我将从IC封装和IC载板技术方面谈起,更详细地介绍Fan-Out WLP、SLP和SiP,为PCB产业后续发展和远景规划提供建议。
IC封装技术发展趋势(含IC载板、Fan-Out WLP、SLP和SiP)
电子制造产业链包含前端的高端电子产业链(IC设计、IC制造和IC封装)和后端的SMT贴件及组装,所以IC封装技术属于高端电子制造领域极其重要的一环,其技术发展趋势同样受摩尔定律的影响,当然现阶段同样受困于摩尔定律的局限性影响。随着高速数据传输的需求及无线技术的飞速发展,沿着深度摩尔的方向,芯片尺寸不断缩小,I/O数不断增加,传统的IC封装正逐渐由Lead frame、Wire Bonding转向Flip Chip,见图5,从而避免互联通道过长对数据传输通道造成的信号损失;当IC制造受到诸多限制因素,摩尔定律逐渐趋缓时,人们不得不开辟超越摩尔的发展道路,从最初的单个IC对应单个载板的封装走向多个IC对应单个载板的SiP封装(2D、2.5D、3D封装)。
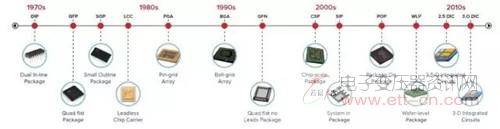
图 5 封装技术发展Timeline
为了更详细的了解IC封装技术及其所包含的IC载板技术,我们需要将视角由摩尔定律转向IC实际应用。纵观ICT时代,电子制造技术的主要驱动来源于两个方面:第一,以智能手机为核心的消费电子,第二,以大数据云计算为核心的高性能计算机,不同的应用对应不同的IC封装和IC载板,见图6:
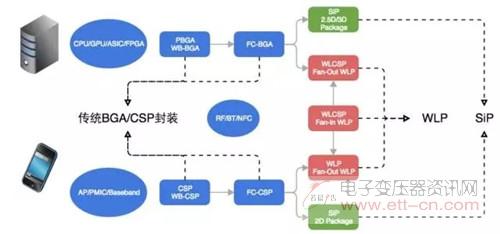
图 6 IC封装应用及演变趋势
从图中我们也可看出,主流IC封装主要包括3个大类:传统BGA/CSP封装、WLP封装和SiP,所以我将从以下三大类封装阐述IC载板、SLP、FoWLP及SiP的差异。
传统BGA/CSP封装及IC载板
广义上的封装包括两部分,一级封装IC载板和二级封装PCB(SMT),我们所说传统的BGA/CSP封装即为一级封装,即把裸芯片通过wire bonding或是flip chip的方式与IC载板进行互联然后塑封即完成了封装,见图7:

图 7 封装等级
由于一级封装时,IC裸芯片与IC载板互联时一般采用高熔点的铅锡合金,熔点在300度以上,高出二级封装SMT焊接温度260度40多度,所以对IC载板的耐热性及CTE(α2 X、Y CTE 5-7ppm/℃)要求极高,这就是IC载板使用的板料必须为高刚性低CTE BT板料或FR5板料的原因,也是IC载板区别于PCB(α2 X、Y CTE 15ppm/℃)的第一大特点。
IC载板的类型
应用于智能手机的消费电子IC封装主要考虑便携性、低成本等因素,一般采用CSP封装,封装尺寸较小,而应用于高性能计算机的IC封装,主要考虑性能,一般采用较为大型的、I/O数非常多的BGA封装。目前主流的IC载板类型见表格1: