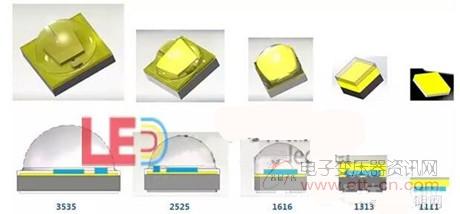
图4 大功率陶瓷LED尺寸缩小以降到成本并提高发光密度,直至彻底去除基板.
二、下一代白光封装趋势
什么是CSP封装?与NCSP有哪些不同?又具有哪些优势?IPC标准J-STD-012对CSP封装的定义是封装体的面积不大于芯片面积的20%。
1、CSP与 NCSP (免基板vs带基板)
当陶瓷基板的尺寸做到和芯片尺寸几乎一样大小时,其逐渐失去了帮助LED散热(热扩散)的功能。相反,如果去掉陶瓷基板,则去掉了一层热界面,有利于热的快速传导到线路板。同时,随着倒装芯片的成熟,陶瓷基板作为绝缘材料对PN电极线路的再分布(re-distribution)的功能已不再需要。除了在机械结构和热膨胀失配上对LED起到一定保护作用,陶瓷基板对芯片的电隔离和热传导的重要功能已基本丧失。
免去基板同时是传统陶瓷封装固晶所需的GGI或AuSn共晶焊接可以改为低成本的SAC焊锡。并借助倒装芯片,免去金线及焊线步骤,降低了封装成本。

图5 典型大功率陶瓷封装结构及其散热
2、白光CSP的优势
除了上述提到的潜在降低成本优势外,在灯具设计上,由于CSP封装尺寸大大减小,可使灯具设计更加灵活,结构也会更加紧凑简洁。在性能上,由于CSP的小发光面、高光密特性,易于光学指向性控制;利用倒装芯片的电极设计,使其电流分配更家均衡,适合更大电流驱动;Droop效应的减缓,以及减少了光吸收,使CSP具有进一步提升光效的空间。在工艺上, 蓝宝石使荧光粉与芯片MQW区的距离增加,荧光粉温度更低,白光转换效率也更高。
3、CSP的工艺技术
实现CSP的白光工艺有多种方式,最理想的荧光粉涂布是在晶圆Wafer上进行,这种封装过程又称晶圆级封装(WLP)。然而,采取这样工艺实现的荧光粉涂布,只覆盖了芯片的表面,蓝光通过蓝宝石从四周漏出,影响色空间分布的均匀性。如果芯片厂不是采取WLP(晶圆级封装)的方式来实现荧光粉涂覆,其进行CSP生产并不比封装厂更具备优势。虽然可以去除蓝宝石,采用薄膜芯片(TFFC)或垂直结构芯片(LLO)可以减少漏光,但工艺成本非常高。
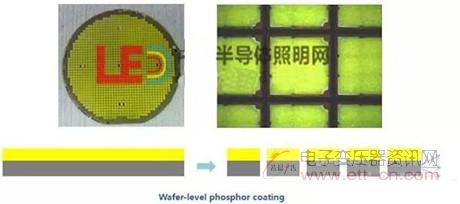
图6 晶圆级荧光粉涂覆后再切方片的工艺所导致的蓝光泄漏
因此,市面上主流技术路线仍是把圆片切割后,在方片上进行荧光粉涂布,再测试、编带,此过程与传统封装工艺更加相似。核心工艺围绕着荧光粉的涂布技术,包括喷胶,封模,印刷、及荧光膜贴装等多种方式,各工艺都有其优势与挑战。

图7 常见的四种在方片上涂覆荧光粉实现CSP的工艺技术
4、CSP的结构与光学
常见的CSP光学结构则分为5面发光和单面发光两种,其发光角度不同,分别是160度左右和120度左右。5面发光CSP更适合应用在全周光球泡灯,如果采用中小尺寸倒装芯片,还可在灯管及测人式电视背光中使用。而单面发光CSP则适合指向性光源,或用于搭配二次光学应用在射灯、路灯、直下式电视背光和闪光灯等。
三、白光CSP的应用前景与挑战
CSP的主要应用在哪里?当前市场应用中的难点又有哪些?有人称CSP为“免封装”,那么中游封装企业未来又将何去何从?