将拆解后的库存新品的Wire 绕制上在不良品之Core 上,感值恢复为29.8uH;
将拆解后的不良品的Wire 绕制上在库存新品之Core 上,感值为17.1uH,同样出现感值偏低现象。
因此初步排除Core 不良之原因,不良的问题点是出现在Wire方面。
经典案例分享:
1 .芯片电感

机械/外力异常分析---本体Crac k裂痕或破损: BhLednc
2 .功率电感
电气异常分析---内电极熔化Crack裂痕开路:
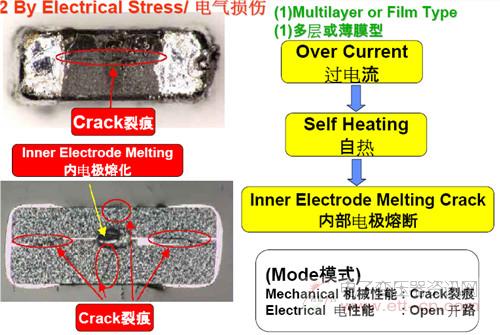
电气异常分析---绕线熔化烧焦致开路或层间短路
总结:
(1)熟知零件的组成结构,材料,制程和特性
(2)FA一般流程
第一步:弄清零件异常的背景:
例如:不良率,异常现象,零件Date Code, 发生不良的流程,pcb上 发生异常的位置,终端产品及客户等
第二步:无损检查
外观检查(六面显微境下观察:变形、破损、变色、异物、开/短路、烧融等);以上若无法断定,可以找良品或其他家的零件与其比对检查
X-Ray 分析/SAM超声波扫描: 检查零件内部有无明显异常(开/短路,分层,内部有空洞/汽泡等)
SEM EDS成份分析---若外观发现有异物
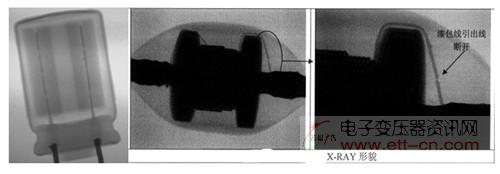
第三步:电性检查
能从基本电性来初步推断零件的失效的可能原因和失效现象:
这里得清楚零件每个电性参数的含义,以及导致某个参数偏大或偏小的可能原因有哪些?
第四步:破坏性分析DPA
切片、零件拆解:
切片的方法:
怎么切?方向和位置如何来确定?
以下图片就是切片的方向和位置
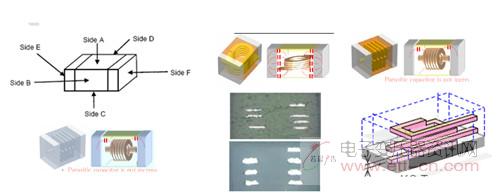

(敬请关注微信订阅号:dzbyqzx)